近期,台积电在高端计算芯片封装领域取得了显著进展,正深入推进CoWoS封装技术。该技术旨在打造面积接近8000平方毫米、功耗高达1000W级别的巨型芯片,性能有望比标准处理器高出40倍。这一创新不仅展示了台积电在封装技术上的领先实力,更为未来巨型芯片的发展奠定了基础。

目前,台积电CoWoS封装芯片的中介层面积已可达到2831平方毫米,远超光罩尺寸极限。NVIDIA B200、AMD MI300X等高端芯片均采用此封装技术,将大型计算模块与多个HBM内存芯片高效整合。然而,台积电并未止步,计划在未来推出更为先进的CoWoS-L封装技术。
据悉,下一代CoWoS-L封装技术的中介层面积将扩展至4719平方毫米,可整合最多12颗HBM内存,包括下一代HBM4。更令人瞩目的是,台积电还在研发中介层面积达到7885平方毫米的封装技术,这将需要18000平方毫米的基板,能封装4颗计算芯片、12颗HBM内存及其他IP,尺寸已超标准CD光盘盒。
巨型芯片的发展不仅依赖于先进的封装技术,还面临着高功耗、高发热的挑战。为此,台积电计划在CoWoS-L封装内直接集成电源管理IC,以缩短供电距离、减少有源IC数量,从而改进系统级供电效率。同时,直触式液冷、浸没式液冷等散热方案也在考虑之中。
此外,台积电还在研究SoW-X晶圆级封装技术,目前仅被Cerabras、特斯拉等企业采用。随着技术的不断进步,巨型芯片的应用领域将进一步拓展,为科技行业带来更多机遇与挑战。
综上所述,台积电在巨型芯片封装技术上的持续创新,不仅推动了芯片性能的飞跃,也为科技行业的发展注入了新的活力。然而,如何在确保性能的同时解决功耗和散热问题,将是台积电及整个行业未来需要共同面对的重要课题。


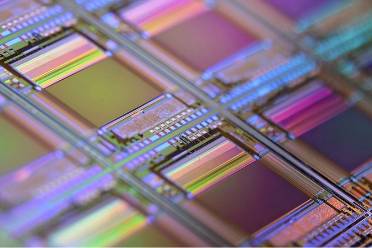


























 浙公网安备 33010502007447号
浙公网安备 33010502007447号